Rasterelektronenmikroskopie
Die Rasterelektronenmikroskopie (REM-Analyse) nutzt Elektronenstrahlen, um detaillierte Bilder von Oberflächen zu erzeugen. Damit können Mikrostrukturen präzise mit großer Vergrößerung untersucht und Materialanalysen durchgeführt werden. Materialanalysen werden durch Materialkontrastaufnahmen (BSE) sowie durch Röntgenmikroanalyse (EDX) oder Röntgenfluoreszenzanalyse (RFA, eng. XRF) zur Bestimmung der chemischen Elemente des Materials durchgeführt.
Hier sind einige der wichtigsten Anwendungsgebiete der Rasterelektronenmikroskopie:
- Aufnahmen hoher Auflösung: REMs bieten eine wesentlich höhere Auflösung im Vergleich zu Lichtmikroskopen. Dies ermöglicht die Betrachtung von Strukturen in Nanometergröße.
- Oberflächenabbildung: REMs eignen sich besonders gut für die Untersuchung von Oberflächenstrukturen von Materialien. Dies ist wichtig in verschiedenen wissenschaftlichen Bereichen, wie Materialwissenschaft, Geologie, Biologie und Nanotechnologie.
- Analyse von Materialzusammensetzung: Mit dem REM können auch Informationen über die chemische Zusammensetzung von Proben gewonnen werden. Durch die Verwendung von energiedispersiver Röntgenspektroskopie (EDX) oder der Röntgenfluoreszenzanalyse (RFA/XRF) kann man die Elemente identifizieren, die in einer Probe enthalten sind.
Als Auftragslabor bieten wir REM Analysen als Dienstleistung an.
- Bildaufnahmen mit hoher Auflösung und Vergrößerung
- Mikrostrukturanalyse
- Chemische Analyse von Materialien
- Werkstoffbestimmung
- Untersuchung von Korrosion und Oxidation
- Untersuchung von Schadensfällen
- Herkunftsbestimmung von Partikeln, Spänen, Ablagerungen
- Fehleranalyse bei Haftfestigkeitsproblemen Beschichtungen
- Schichtdickenmessung von dünnen Beschichtungen
- Kristallografie metallischer Proben
Was bietet unser Steinbeis-Transferzentrum?
1. Modernste Technologie
Wir setzen auf moderne Analysegeräte, um präzise und reproduzierbare Ergebnisse zu gewährleisten.
2. Fachkundige Expertise
Unser qualifiziertes Team von Materialwissenschaftlern/innen steht Ihnen gerne zur Verfügung, um Ihre Fragen zu beantworten.
3. Kundenzentrierter Ansatz
Jeder Auftrag ist individuell und deshalb sind unsere Analysen auf die jeweiligen kundenspezifischen Anforderungen zugeschnitten.
Kontaktieren Sie uns gerne für eine REM Analyse!
Optimieren Sie Ihre Produktentwicklung und Qualitätssicherung mit unserer REM Analyse. Kontaktieren Sie uns für weitere Informationen oder um ein individuelles Angebot für Ihre Anforderungen zu erhalten.
Gerne erstellen wir Ihnen ein Angebot für eine REM Analyse.
Mikrostrukturanalyse
Bei der Rasterelektronenmikroskopie (REM Analyse) wird die Mikrostruktur einer Oberflächen mit Hilfe eines Elektronenstrahls sehr fein untersucht. Dazu wird ein Primärelektronenstrahl mit Hilfe einer Elektronenkathode zur Beschleunigung zur Anode hin erzeugt. Anschließend wird dieser Elektronenstrahl durch elektromagnetische Linsen auf die Oberfläche des zu untersuchenden Objektes fokussiert und wird zeilenförmig über das darzustellende Objekt gerastert. Die dabei stattfindende Wechselwirkung der Elektronen mit der Oberfläche wird analysiert.
Der Sekundärelektronenkontrast (SE) bildet die Oberflächentopografie ab, da die energiearmen Sekundärelektronen aus inelastischen Stößen mit den oberflächennahen Bereichen entstammen. Materialanalysen erfolgen mit dem Materialkontrast (BSE), der durch die Rückstreuelektronen (RE) entsteht, die aus inelastischer als auch elastischer Streuung resultieren, welche den Energiebereich oberhalb der SE abdecken. Die Signalintensität ist dabei von der Ordnungszahl der Elemente abhängig. Schwere Elemente (hohe Ordnungszahl) führen zu einer stärkeren Rückstreuung und erscheinen hell. Die leichteren Elemente (niedrige Ordnungszahl) erscheinen dunkel.
MATERIALANALYSE (EDX, RFA / XRF)
Materialanalysen können mit der energiedispersiven Röntgenspektroskopie (EDX) durchgeführt werden. Damit erfolgt die Bestimmung der chemischen Elemente, deren Konzentration und Verteilung. Die EDX Analyse gehört zur Röntgenmikroanalyse und beruht darauf, dass jedes chemische Element eine charakteristische Röntgenstrahlung aussendet, wenn es angeregt wird. Die Anregung erfolgt durch den Primärelektronenstrahl des Rasterelektronenmikroskops. Dabei kommt es durch die Elektronen in der Atomhülle zur Aussendung einer Röntgenstrahlung, deren Spektrum für jedes Element charakteristisch ist. Man unterscheidet Spotanalysen (punktuell), Linienanalysen (line scans) und Flächenanalysen (Elementmapping). Mit einem Mapping wird die Verteilung der chemischen Elemente über eine Fläche ermittelt, wodurch lokale Unterschiede bestimmt werden.
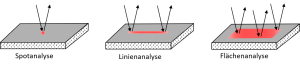
Eine weitere Methode für Materialanalysen, insbesondere für sehr geringe Konzentrationen, ist die Röntgen-Fluoreszenz-Analyse (RFA), im Englischen X-RAY Fluorescence Spectroscopy (XRF). Dabei handelt es sich um eine spektroskopische Technik, mit welcher sich die Identitäten und die Konzentrationen von chemischen Elementen bestimmen lassen. Die Nachweisgrenzen sind abhängig von zu bestimmenden Element und liegen im Bereich von ca. 10 ppm. Des Weiteren lassen sich dadurch Schichtdicken von dünnen Beschichtungen im Bereich von 5 nm bis 10 µm bestimmen.
Schichtdickenmessung
Mit dem Rasterelektronenmikroskop (REM), dem Röntgenstrahler (RFA) und dem Röntgenstrahldetektor (EDX) werden präzise Schichtdickenmessungen, entweder am Querschliff oder von der Oberfläche aus durchgeführt:
- Am präparierten Querschliff werden Materialkontrastaufnahmen mit dem BSE Detektor angefertigt in denen die unterschiedlichen Elemente in verschiedener Helligkeiten dargestellt werden. Dann können die jeweiligen Dicken der Beschichtungen ausgemessen werden.
- Am präparierten Querschliff werden Elementanalysen mit der energiedispersiven Röntgenspektroskopie (EDX) als Linienanalysen über den Bereich der Beschichtung durchgeführt. Anhand der Breite der Elementverteilung werden dann die Schichtdicken bestimmt.
oder von der Oberfläche aus:
- Die Röntgenfluoreszenzanalyse (RFA, XRF) erlaubt die Bestimmung der Schichtdicke und Zusammensetzung einzelner Schichten, Mehrfachschichten, wie auch Legierungsschichten. Möglich ist eine gleichzeitige Messung von Schichtsystemen mit mehreren Schichten oder die gleichzeitige Messung der Dicke und Zusammensetzung von Schichten mit mehreren Bestandteilen. Damit können Schichtdicken vom Nanometer- bis zum Mikrometerbereich bestimmt werden.
- Bei der energiedispersiven Röntgenspektroskopie (EDX) wird die Beschichtung von der Oberfläche aus über die Tiefe mit verschiedenen Beschleunigungsspannungen “abgerastert” wird. Dies wird für Beschichtungen mit Schichtdicken im Bereich von 5 – 200 nm eingesetzt.
Stereoskopische 3D-Rekonstruktion REM-Aufnahme

